(報告出品方/作者:,周爾雙、李文意)
半 導 體 封 裝 技 術 不 斷 發 展 , 鍵 合 種 類 多 元
鍵合主要作用為將兩片晶圓進行結合,分類標準多樣
鍵合(Bonding)是通過物理或化學的方法將兩片表麵光滑且潔淨的晶圓貼合在一起,以輔助半導體製造工藝或 者形成具有特定功能的異質複合晶圓。鍵合技術有很多種,通常根據晶圓的目標種類可劃分為晶圓-晶圓鍵合 (Wafer-to-Wafer,W2W)和芯片-晶圓鍵合(Die-to-Wafer,D2W);根據鍵合完成後是否需要解鍵合,又可 分為臨時鍵合(Temporary Bonding)和永久鍵合(Permanant Bonding);根據待鍵合晶圓間是否引入輔助界 麵夾層,還可分為直接鍵合、間接鍵合、混合鍵合(Hybrid Bonding)等;根據傳統和先進與否,傳統方法包 括引線鍵合(Wire Bonding),先進方法采用倒裝芯片鍵合(Flip Chip Bonding)、混合鍵合等。
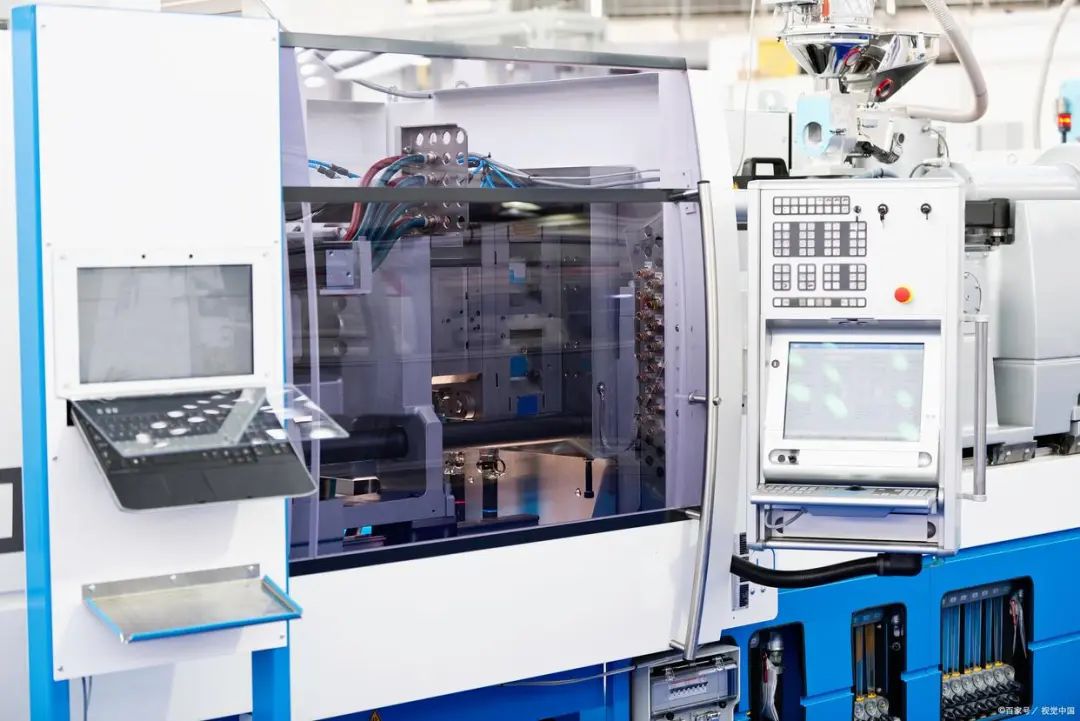
傳 統 封 裝 方 式 主 要 為 引 線 鍵 合 , 實 現 電 氣 互 聯
傳統封裝依靠引線實現電連接,可分為通孔插裝和表麵貼裝類
傳統封裝需要依靠引線將晶圓與外界產生電氣連接。將晶圓切割為晶粒後,使晶粒貼合到相應的基板架上,再 利用引線將晶片的接合焊盤與基板引腳相連,實現電氣連接,最後用外殼加以保護。 傳統封裝大致可以分為通孔插裝類封裝以及表麵貼裝類封裝。20世紀70年代人們通常采用雙列直插式封裝 (DIP)或鋸齒型單列式封裝(ZIP)等通孔型技術,即將引線插入到印刷電路板(PCB)的安裝孔中;後來, 隨著引腳數量的不斷增加以及PCB設計的日趨複雜,通孔插裝技術的局限性也日益凸顯,薄型小尺寸封裝 (TSOP)、四方扁平封裝(QFP)和J形引線小外形封裝(SOJ)等表麵貼裝型技術陸續問世。
引線鍵合根據鍵合能量使用的不同可以分為熱壓鍵合法、超聲鍵合法和熱超聲鍵合法。(1)熱壓鍵合法: 利用微電弧使鍵合絲的端頭熔化成球狀,通過送絲壓頭壓焊在引線端子上形成第一鍵合點;而後送絲壓頭 提升移動,在布線板對應的導體布線端子上形成第二鍵合點,完成引線連接過程。(2)超聲鍵合法:超 聲鍵合法主要應用於鋁絲的引線連接,超聲波能量被鋁絲中的位錯選擇性吸收,使鋁絲在非常低的外力作 用下可處於塑性變形狀態,鋁蒸鍍膜表麵上形成的氧化膜被破壞,露出清潔的金屬表麵,便於鍵合。 (3) 熱超聲鍵合法:在超聲鍵合機中引入加熱器輔助加熱,鍵合工具采用送絲壓頭,並進行超聲振動,具有更 高的效率和更廣泛的用途,但是工藝過程較複雜。
引線鍵合機海外K S、ASMPT為龍頭,CR2約80%
受下遊需求影響及我國設備商國產替代加速,2024年我國引線鍵合機進口市場空間約6.18億美元,仍顯著低於 2021年高峰期進口市場空間的15.9億美元。進口引線鍵合機包括金銅線鍵合機和鋁線鍵合機。其中鋁線鍵合機 數量占比約為10~15%,約3000-4000台,單台價值量約為25萬美元,市場空間約為40-50億元人民幣;金銅線鍵 合機數量占比約為85~90%,單台價值量較低,約為5-6萬美元,市場空間約80億元人民幣左右。
海外K S(庫力索法)、ASM為半導體鍵合機龍頭,2021年CR2約80%。鋁線鍵合機為K S在2010年收購的美 國公司OE業務,鍵合機本身也屬於焊接,符合K S的生產文化,2020年之前汽車電子、功率器件,尤其是汽車電子市場K S市占率高達90%, K S的Asterion和PowerFusion產品競爭力較強;2020年下半年以來浮現出了競 爭對手,如ASMPT、等,K S在逐步減少功率器件IGBT市場的投入,將重心逐步放至汽車電子 。國外 龍頭單台售價25萬美金/台(對應人民幣約180萬元),國產設備130萬人民幣左右。
先 進 封 裝 快 速 發 展 , 熱 壓 鍵 合 、 混 合 鍵 合 為 未 來趨勢
後摩爾時代下封裝追求更高的傳輸速度、更小的芯片尺寸
封裝逐步朝著高速信號傳輸、堆疊、小型化、低成本、高可靠性、散熱等方向發展。(1)高速信號運輸: 人工智能、5G等技術在提高芯片速度的同時還需要提升半導體封裝技術,從而提高傳輸速度;(2)堆疊: 過去一個封裝外殼內僅包含一個芯片,而如今可采用多芯片封裝(MCP)和係統級封裝(SiP)等技術,在 一個封裝外殼內堆疊多個芯片;(3)小型化:隨著半導體產品逐漸被用於移動甚至可穿戴產品,小型化成 為一項重要需求。
鍵合方式逐步從引線鍵合、倒裝鍵合、熱壓鍵合再到混合鍵合
封裝形式演變下,鍵合技術追求更小的互聯距離以實現更快的傳輸速度。封裝技術經曆了從最初通過引線框架 到倒裝(FC)、熱壓粘合(TCP)、扇出封裝(Fan-out)、混合封裝(Hybrid Bonding)的演變,以集成更多 的I/O、更薄的厚度,以承載更多複雜的芯片功能和適應更輕薄的移動設備。在最新的混合鍵合技術下,鍵合的 精度從5-10/mm2提升到10k+/mm2,精度從20-10um提升至0.5-0.1um,與此同時,能量/Bit則進一步縮小至 0.05pJ/Bit。
為了使芯片尺寸更小,封裝尺寸和凸點間距都需要相應地縮小;10的凸點間距提供的I/O數量大約是200 凸點間距的400倍。隨著電子器件朝著更輕薄、更微型和更高性能的方向發展,凸點間距已經推進到20,並 且一些行業巨頭已經實現了小於10的凸點間距;10凸點間距所提供的I/O數量大約是200凸點間距的 400倍。
50-40凸點間距可通過倒裝鍵合實現,40-10凸點間距需用熱壓鍵合(TCB),而10以下凸點間距則需 采用混合鍵合技術。(1)倒裝鍵合的回流焊適用於40-50凸點間距,但隨著凸點間距縮小會導致翹曲和精度 問題,使回流焊不再適用。(2)熱壓鍵合40-10凸點間距中能夠勝任,但當凸點間距達10時,TCB可能 產生金屬間化合物,影響導電性。(3)10凸點間距以下的高集成度封裝將全麵轉向混合鍵合技術。
倒裝鍵合取代引線鍵合應用於CPU、GPU與DRAM封裝
倒裝鍵合是通過在芯片頂部形成的凸點來實現芯片與基板間的電氣和機械連接。與傳統引線鍵合一樣,倒片 封裝技術是一種實現芯片與基板電氣連接的互連技術。相較於引線鍵合,倒裝鍵合①擁有更多的連接密度, 引線鍵合隻能圍繞芯片四周進行引線連接,對於可進行電氣連接的輸入/輸出(I/O)引腳的數量和位置有限製, 而倒裝鍵合可以在整個芯片正麵植球,可以顯著提高連接密度; ②信號傳輸路徑更短:倒裝鍵合直接利用凸 塊(Bump)進行電信號傳輸,傳輸路徑遠短於引線鍵合,可以帶來更快的計算傳輸能力。因此在先進封裝領域, 倒裝鍵合技術憑借其優越的電氣性能和空間利用率成為主流鍵合技術,被廣泛應用於CPU、GPU和高速 DRAM芯片的封裝。
熱壓鍵合適用於超細間距、高密度互聯封裝
為解決芯片凸點間距縮小時倒裝鍵合回流焊步驟中出現的翹曲和精度問題,當凸點間距達40以下時,TCB (Thermal Compression Bonding)熱壓鍵合成為主流。TCB鍵合利用高精度相機完成待鍵合芯片間的對準, 並通過控製熱壓頭的壓力與位移接觸基座,施加壓力並加熱以實現芯片間的鍵合。
TCB從芯片頂部加熱,僅芯片和C4(可控熔塌芯片互連, Controlled Collapse Chip Connection )焊料會升 溫,最大限度減少基板、裸片翹曲傾斜問題。壓力確保均勻粘合,無間隙變化或傾斜。TCB技術在相同I/O間 距下實現更好的電氣特性,並允許I/O間距繼續縮小,可封裝更薄的芯片,因此多疊層HBM3通常采用TCB。
熱壓鍵合市場主要由海外企業壟斷,CR5約88%
根據QY Research數據,2023年全球熱壓鍵合機(TCB)市場銷售額達到了1.04億美元,預計到2030年將達 到2.65億美元,年複合增長率為14.5%。隨著半導體技術向更小尺寸、更高集成度方向發展,熱壓鍵合機作 為先進封裝技術的核心設備,需求顯著增加。特別是在HBM3應用,其多層芯片堆疊技術依賴熱壓鍵合工藝, 推動了熱壓鍵合機市場的快速增長。
全球熱壓鍵合機市場主要由海外企業壟斷,主要參與者包括ASMPT、K S、BESI、Shibaura和SET,前五 大製造商的市場份額(CR5)約為88%。由ASMPT官網,其熱壓鍵合機包括FIREBIRD TCB係列,主要用於 異構集成的芯片2D、2.5D及3D封裝,已批量交付超過250台,是全球TCB熱壓鍵合工藝設備的龍頭廠商。同 時,國產廠商如華卓精科、唐人製造等亦積極布局該領域,國產廠商熱壓鍵合設備市場份額有望逐步擴大。
混合鍵合僅需要銅觸點,能夠實現更高密度互聯
混合鍵合是因其鍵合界麵同時包含金屬和介質或聚合物( 如Cu/SiO2, Cu/SiCN等)兩種材料,通過堆疊接觸方 式將來自不同工藝的晶圓結合在一起實現電氣互聯。混合鍵合不需要金屬引線或微凸點,僅通過銅觸點實現 短距離電氣互連,可在芯片間有望實現更短的互連距離、更高密度、更低成本及更高性能。
典型的Cu/SiO2 混合鍵合主要包括三個關鍵工藝步驟。(1)鍵合前預處理:晶圓需經過化學機械拋光/ 平坦 化(CMP)和表麵活化及清洗處理,實現平整潔淨且親水性表麵;(2)兩片晶圓預對準鍵合:兩片晶圓鍵 合前進行預對準,並在室溫下緊密貼合後介質SiO2 上的懸掛鍵在晶圓間實現橋連,形成SiO2 -SiO2 間的熔融 鍵合,此時,金屬Cu 觸點間存在物理接觸或凹陷縫隙(dishing),未實現完全的金屬間鍵合;(3)鍵合後 熱退火處理:通過後續熱退火處理促進了晶圓間介質SiO2 反應和金屬Cu 的互擴散從而形成永久鍵合。
先 進 封 裝 晶 圓 變 薄 , 臨 時 鍵 合 解 鍵 合 為 階 段 所 需 工 藝
晶圓級堆疊封裝技術催生對超薄晶圓及臨時鍵合工藝需求
晶圓減薄工藝成為先進封裝的核心工藝,超薄晶圓的諸多優點直接推動3D堆疊層數提高。在一些先進的封 裝應用中,需要將晶圓減薄至10以下。①增強散熱:超薄晶圓可以有效降低熱阻,改善先進封裝中晶圓 多層堆疊造成的積熱問題。②增強電學性能:采用超薄晶圓使得元器件間互連長度縮短,從而提高信號的傳 輸速率、減少寄生功耗、提升信噪比。③提高集成度:在三維集成矽通孔TSV技術中采用超薄晶圓,在保證 深寬比的同時可以製造節距更小、密度更高的矽通孔。④降低成本:對超薄晶圓進行刻蝕、鑽孔、鈍化、電 鍍等後續工藝,其加工速度和產量都能大大提高,同時有效降低材料使用成本。
晶圓減薄工藝需要引入臨時鍵合以提供機械支撐。當矽片被減薄到100以下時,晶圓在工藝中產生殘餘應 力、機械強度降低,加之受到自身質量的影響,會表現出顯著的柔性和脆性,很容易翹曲、彎折,甚至破裂。 因此對於超薄晶圓,必須使用外部支撐的方法對其進行保護,便於在超薄晶圓上進行後續工藝並提升芯片製 造中的良率、加工精度和封裝精度,由此催生對臨時鍵合/解鍵合工藝的需求。在背麵減薄前,采用臨時鍵 合的方式將晶圓轉移到晶圓載板上為其提供強度支撐,完成背麵減薄及其他背麵工藝後進行解鍵合。
臨時鍵合工藝可分為臨時熱壓鍵合和UV固化鍵合
臨時鍵合一般有臨時熱壓鍵合和UV固化兩種方式。臨時鍵合首先要將臨時鍵合膠通過旋塗或噴塗方式在器 件晶圓和載片表麵均勻塗布,隨後依靠熱壓臨時鍵合或UV固化臨時鍵合方式,使載片和晶圓鍵合牢固。(1) 熱壓臨時鍵合:在高溫、真空的鍵合室內對疊放在一起的器件晶圓和載片施加一定的力使之達到良好的鍵合 效果;(2)UV固化臨時鍵合:紫外光透過載片照射到鍵合膠表麵發生反應,使載片和器件晶圓鍵合到一起。
臨時鍵合設備的兼容性與對準精度構成核心壁壘
臨時鍵合設備主要由控製係統、上下片機構、旋塗工作台、翻轉機械手、對準係統和UV固化工作台構成。 控製係統控製設備運行時序;上下片機構完成晶圓(和載片)的裝/卸載;旋塗工作台完成在器件晶圓和載 片表麵臨時鍵合膠的塗覆,臨時鍵合膠的均勻性和厚度會直接影響臨時鍵合的效果;翻轉機械手控製晶圓在 不同工位上的傳輸和翻轉;對準係統將載片和器件晶圓對準,再通過CCD圖像係統和X、Y、向運動機構 實現掃描對準;對準完成後,在UV 固化工作台上由紫外光照射同時施加一定的壓力,完成臨時鍵合。
臨時鍵合設備的核心技術壁壘和技術難點在於多材料/高低溫適配性、高對準精度、機械應力控製等。①機 械應力控製:防止超薄晶圓在處理中受到機械應力的影響導致翹曲或碎裂。②高溫適配性:臨時鍵合材料通 常需要加熱進行固化或軟化,設備需要能處理高溫工藝。③高對準精度:晶圓和載板必須精確對準以防止後 續工藝中誤差積累,在涉及多層級光刻工藝時對準精度的要求非常高,國際先進水平小於50nm。④多工藝 兼容性:臨時鍵合設備必須能夠兼容不同的工藝需求,例如不同鍵合材料、不同溫度要求、不同晶圓厚度等。
報告節選:



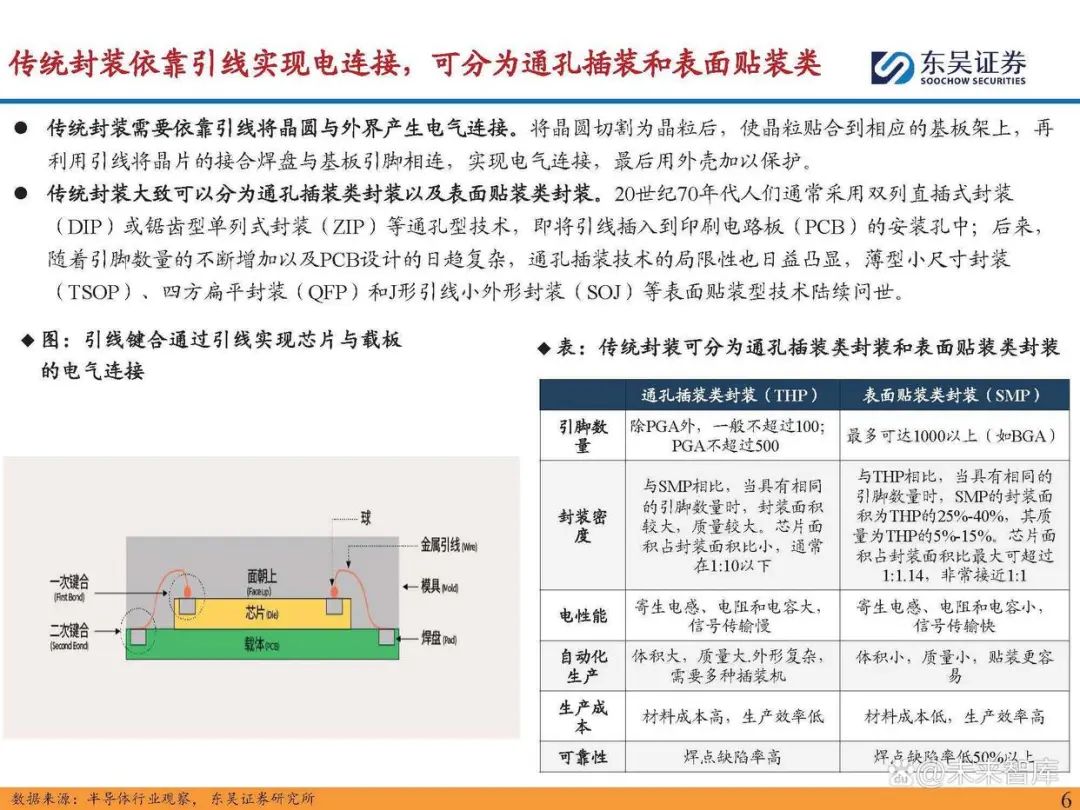



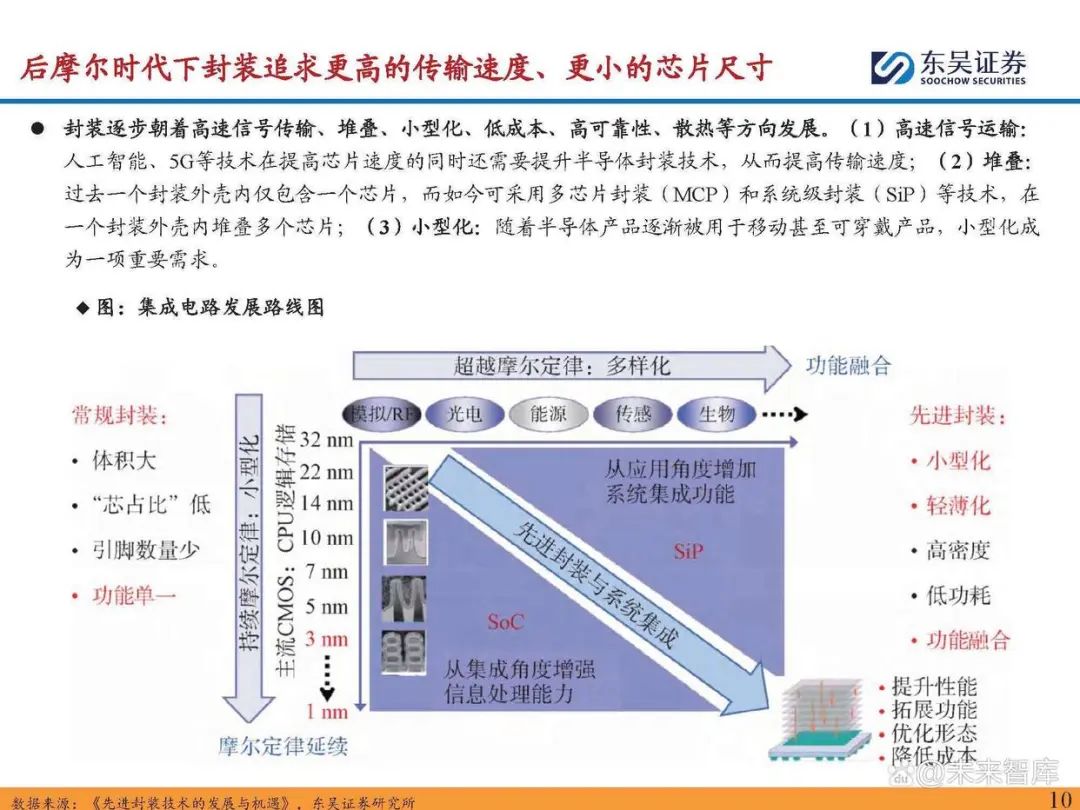

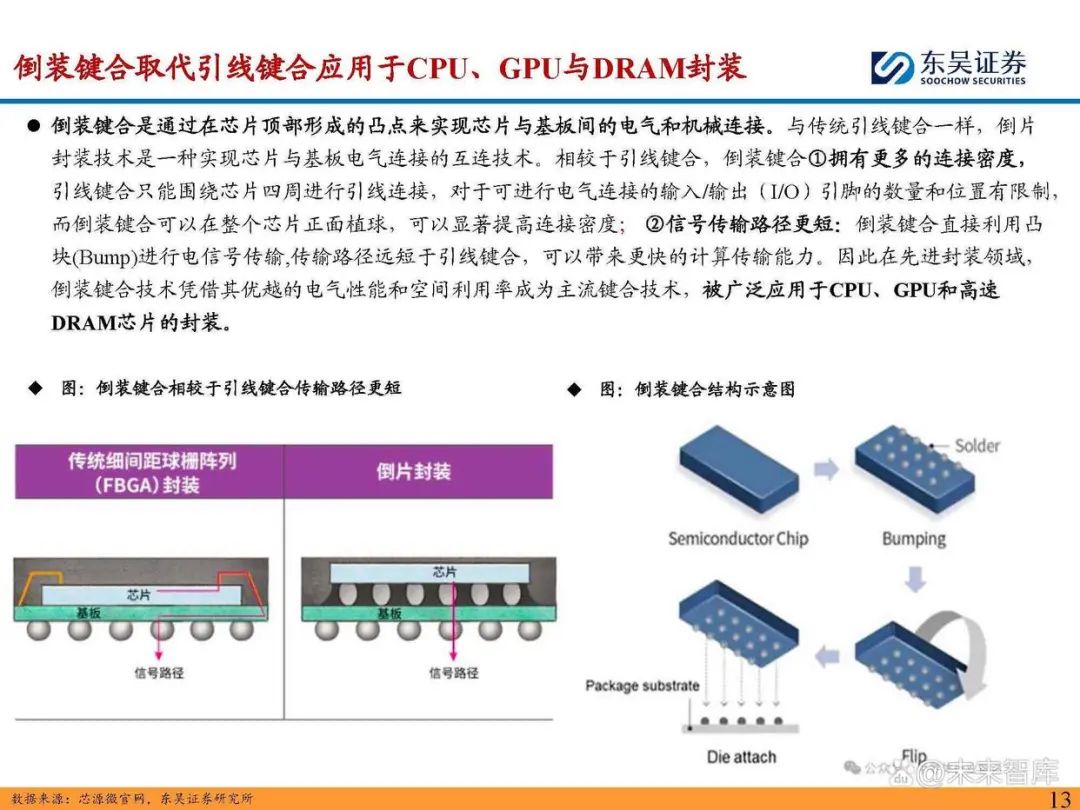


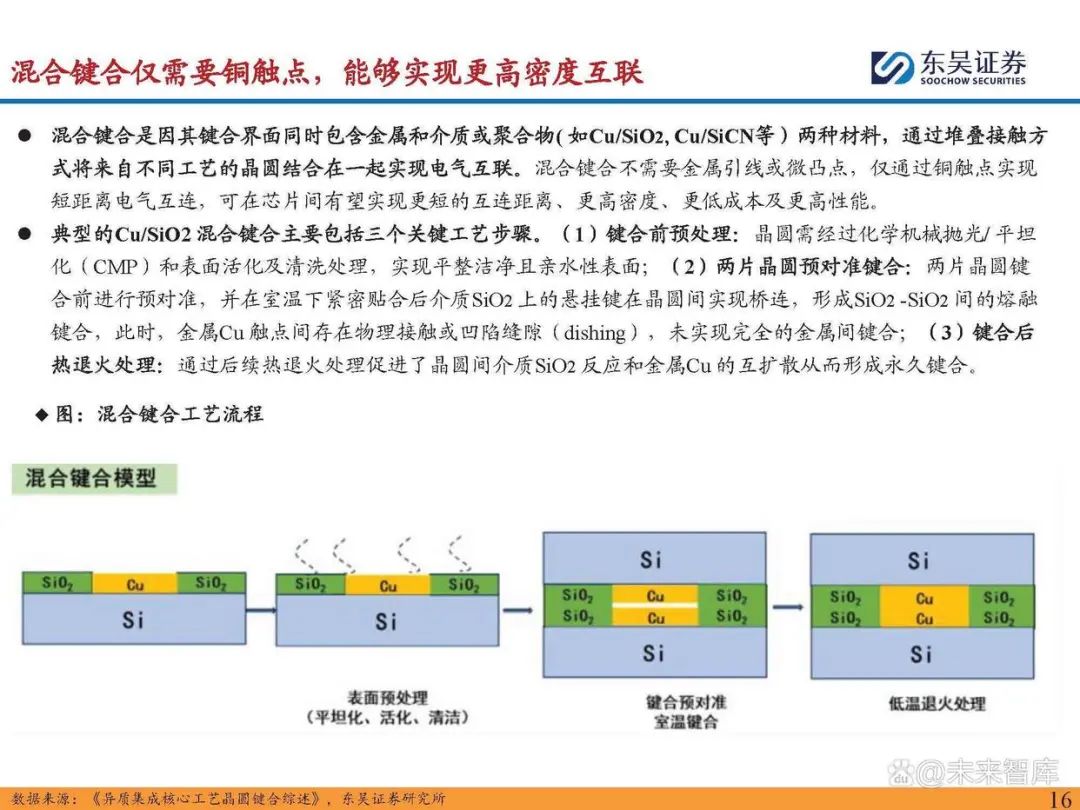

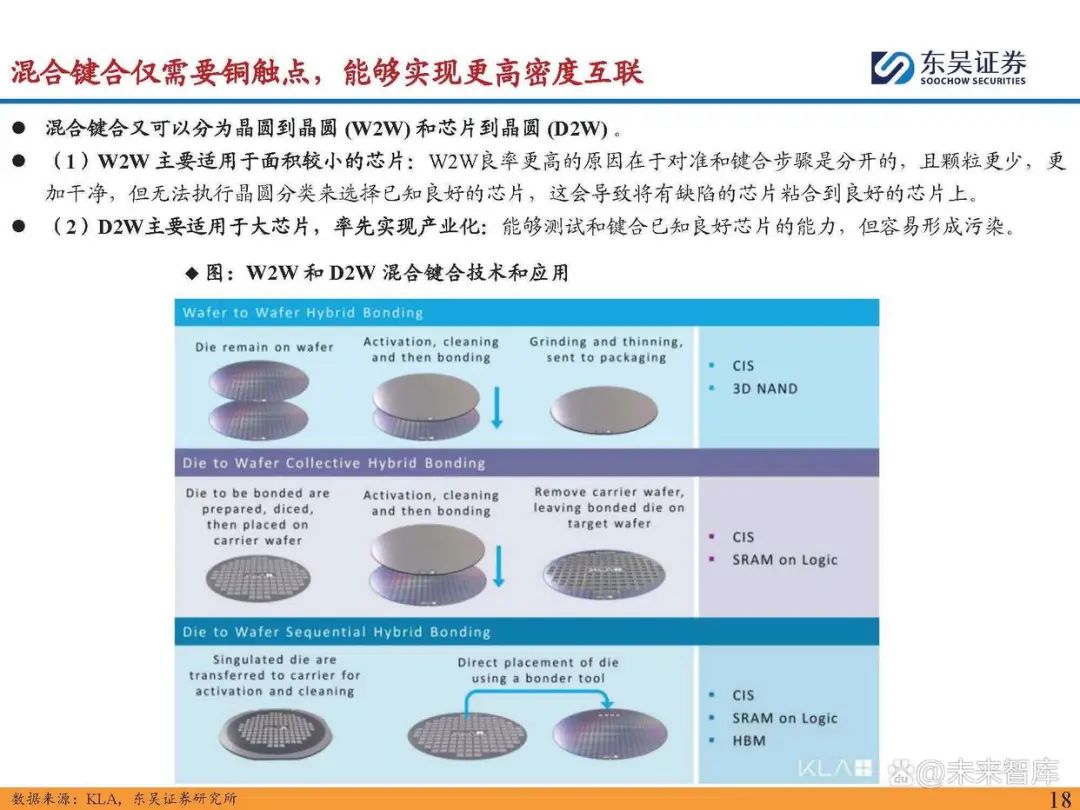
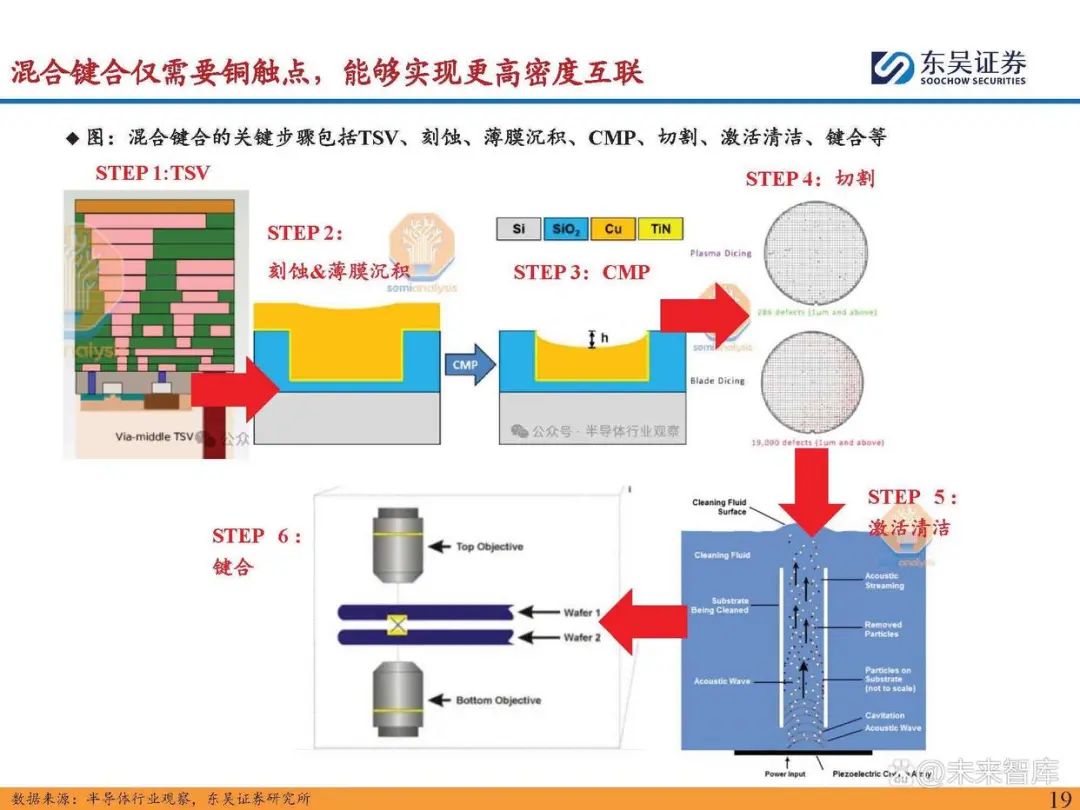


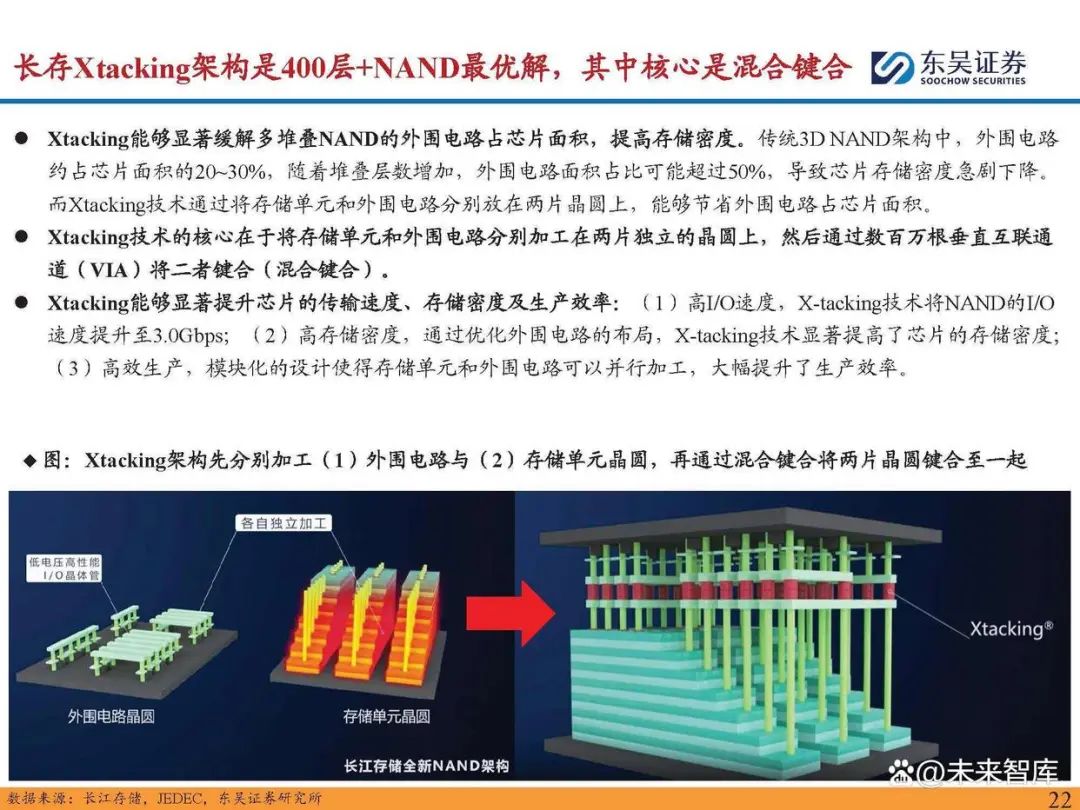



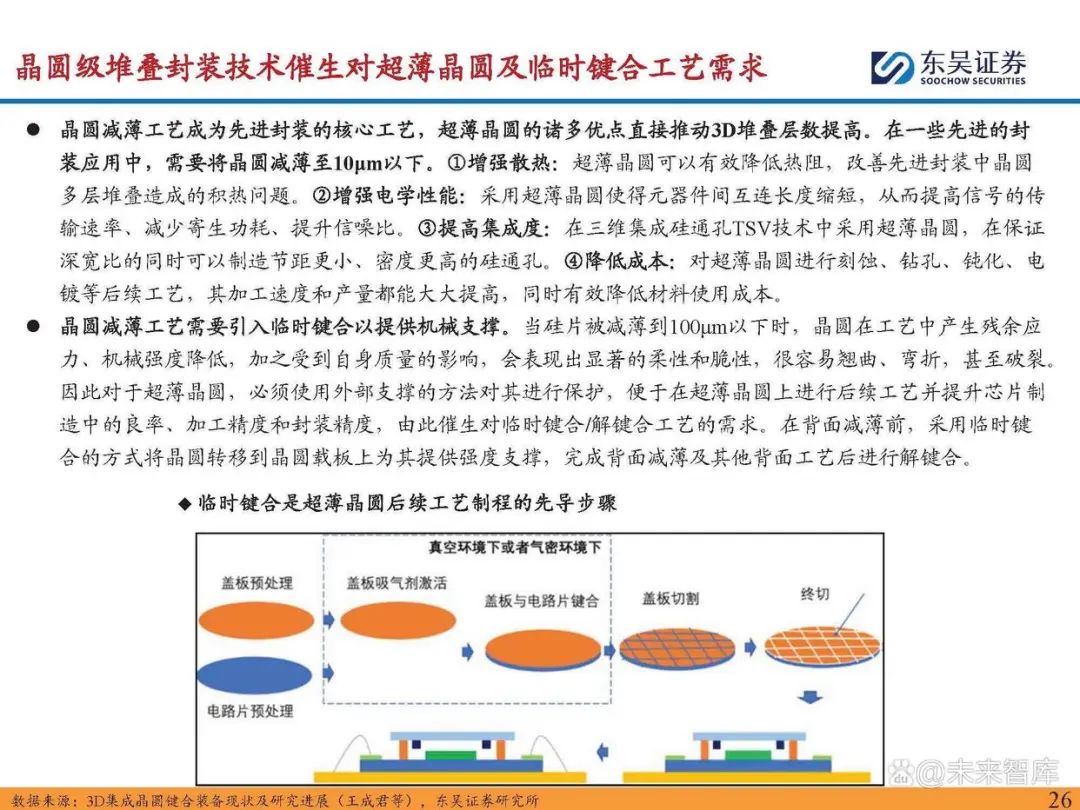
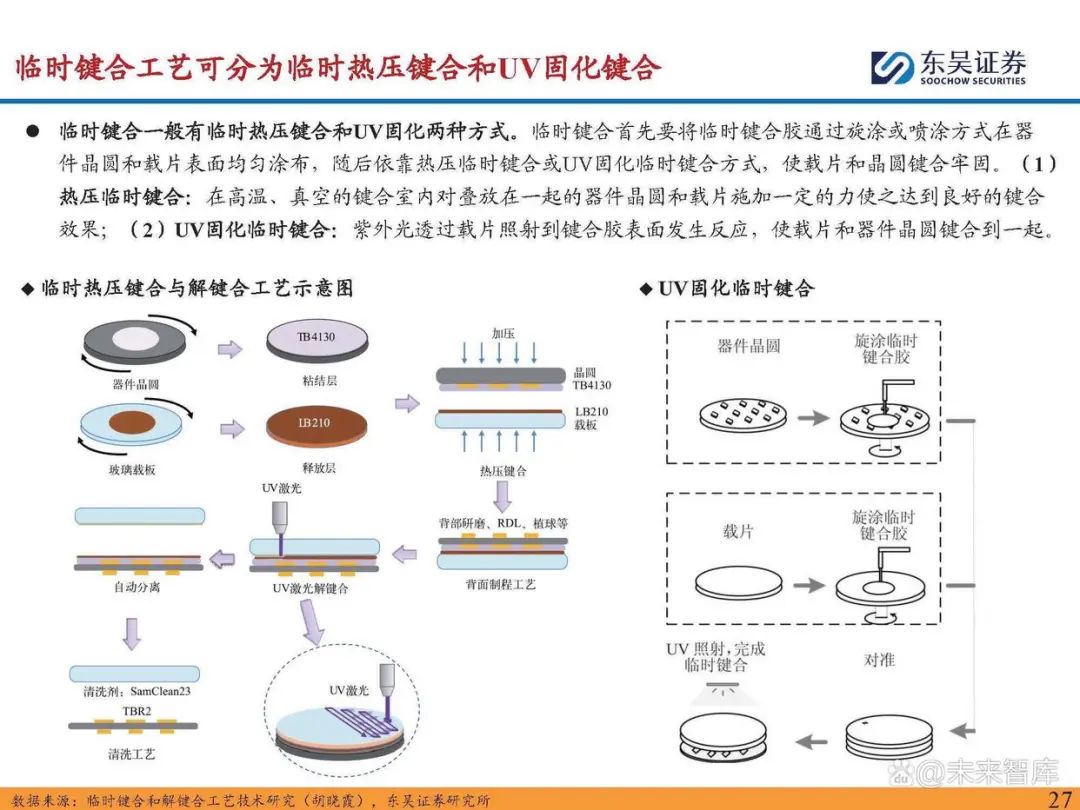













(本文僅供參考,不代表我們的任何投資建議。如需使用相關信息,請參閱報告原文。)
全文完,感謝您的耐心閱讀,請順手點個 在看 吧~